Tyto webové stránky používají soubory cookies, abychom vám mohli poskytnout co nejlepší uživatelský zážitek. Informace o souborech cookie se ukládají ve vašem prohlížeči a plní funkce, jako je rozpoznání, když se na naše webové stránky vrátíte, a pomáhají našemu týmu pochopit, které části webových stránek považujete za nejzajímavější a nejužitečnější.
Vyhledávání
Skenovací elektronový mikroskop (SEM)
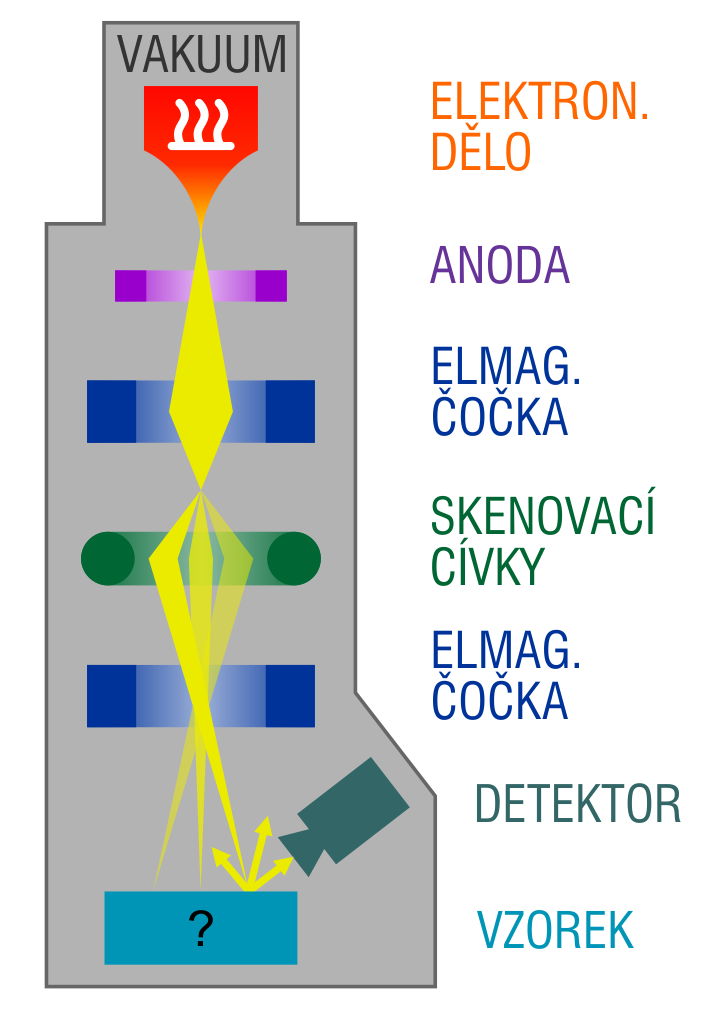
Skenovací (řádkovací) elektronový mikroskop (SEM) je podobně jako klasický mikroskop optický přístroj. Na rozdíl od běžných světelných mikroskopů využívá jako zdroj záření elektrony namísto fotonů a elektromagnetických čoček namísto čoček skleněných. Celý vnitřní prostor mikroskopu, jak samotný elektronový svazek, tak i vzorek, jsou ve vakuu, aby nedocházelo k interakci elektronů s vnější atmosférou. Velikost vzorku není přesně specifikována, hlavním limitujícím faktorem je velikost vakuové komory samotného přístroje, do které se vzorek vkládá. Vzorek pozorovaný v SEM musí být vodivý, tudíž pro pozorování nevodivých materiálů je třeba vzorek předem opatřit vrstvou kovového prášku (tzv. naprášit).
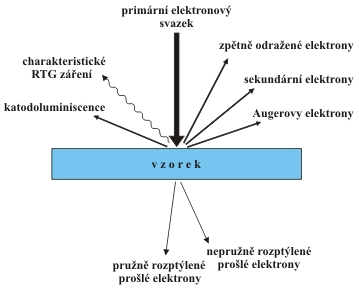
Pro studium či analýzu povrchu využíváme interakce elektronového svazku se vzorkem, čímž získáváme celou řadu informací, ať už mikrostrukturu, krystalografické uspořádání či chemické složení materiálu. Pro jejich získání musí být mikroskop opatřen detektory, které tyto informace sbírají. Zjednodušeně se dá říct, že pro SEM jsou typické informace, které se z povrchu a malého objemu pod povrchem (nazýván interakční objem) odrazí zpět. Podobně je tomu i pro transmisní elektronový mikroskop (TEM), ten ale pro analýzu materiálu využívá signálů, které projdou vzorkem skrz, čímž umožňuje studium jejich vnitřní struktury.
Sekundární elektrony (SE)
Sekundární elektrony (zkratka SE z anglického secondary electrons) jsou elektrony generované přímo z místa dopadu primárního svazku do hloubky maximálně několika desítek nanometrů. Jsou nositeli informace o topografii, čili tvaru povrchu vzorku. Díky velké hloubce ostrosti a vysoké rozlišovací schopnosti (dané užitím elektronů, jejichž vlnová délka je výrazně kratší než u viditelného světla) využíváme obrazu vzniklého zpracováním signálu sekundárních elektronů pro analýzu povrchů a struktur či pro měření rozměrů, např. částic. Jelikož jsou sekundární elektrony detekovány pod určitým úhlem vůči povrchu vzorku, vznikají na obraze světlejší a tmavší místa, která vytvářejí trojrozměrný efekt.
Zpětně odražené elektrony (BSE)
Zpětně odražené elektrony (z angličtiny back scattered electrons) pochází na rozdíl od sekundárních elektronů z větší hloubky interakčního objemu materiálů (desítky až stovky nanometrů) a nesou informaci nejenom topografickou, ale i materiálovou, což je dobře viditelné, budeme-li pozorovat vzorek v obrazovém módu, z prvního a posledního obrázku. Na prvním obrázku jsou vidět částice zlata na uhlíkové podložce. Výrazný kontrast mezi nanesenými částicemi a podložkou je způsobem vysokým rozdílem atomových čísel obou prvků, tzn. vyšší atomové číslo je znázorněno světlejší barvou. Kontrast tedy není způsoben pouze topografií povrchu, jako je tomu u sekundárních elektronů, ale také jednotlivými prvky obsaženými v materiálu. Rozdíl mezi pozorováním stejného objektu pomocí sekundárních a zpětně odražených elektronů je patrný z posledních obrázků u obou kategorií. Zpětně odražené elektrony umožňují pozorování vzorku také v módu difrakce neboli odrazu. Tento mód nám poskytuje informace o krystalografii materiálu, tzn. o orientaci mřížky a mřížkových parametrech, které lze zobrazit v barevných mapách (viz druhý obrázek, metoda EBSD), či v tzv. Kikuchicho obrazcích (třetí obrázek).
RTG záření
Dalším ze signálů, který dopadem primárního svazku elektronů získáváme, je charakteristické rentgenové (RTG) záření. Tento signál pochází z hloubky maximálně v řádech jednotek mikronů interakčního objemu a dává nám, s ohledem na použité detektory, kvalitativní a kvantitativní data o chemickém složení materiálu, tzv. prvková spektra (prvkové složení zkoumaného materiálu). Pro detekci charakteristického RTG záření lze použít detektory EDS (energiově disperzní spektrometrie) či WDS (vlnově disperzní spektrometrie). Rozdíl mezi těmito detektory je značný. Zatímco pomocí WDS analyzujeme prvek po prvku na základě charakteristické vlnové délky RTG záření, pomocí EDS analyzujeme celé vyzářené spektrum. Z toho vyplývá, že metoda EDS je výrazně rychlejší, ale tato rychlost je vykoupena menší přesností a většími detekčními limity (v řádech desetin procenta hmotnostního obsahu prvku), zatímco metoda WDS je sice poměrně zdlouhavá, ale za to velmi přesná a detekční limity se pohybují v řádech setin procenta obsahu prvku. Více o EDS >>
Katoluminiscence a Augerovy elektrony
Zvláštními případy získaných signálů jsou katoluminiscence a Augerovy elektrony. Zatímco katoluminiscence umožňuje pozorování reálného barevného obrazu, jelikož se jedná o viditelné světlo vzniklé interakcí primárního svazku se vzorkem, Augerovy elektrony umožňují prvkovou analýzu materiálu. Jako Augerovy elektrony se označují ty elektrony, které vznikají při přechodu elektronů z vyšších energetických hladin do vakance, při němž se uvolní kvantum energie. Tato energie může být vyzářena ve formě fotonu (charakteristického RTG záření) nebo předána některému elektronu ve vnější slupce, který tím získá dostatek energie k tomu, aby atom opustil a dojde k emisi tzv. Augerova elektronu. Augerovy elektrony se výrazně projevují u lehčích prvků, například uhlík, dusík či bór.
Fokusovaný iontový svazek (FIB)
Speciálním typem SEM mikroskopů jsou dvojsvazkové mikroskopy, které mají kromě primárního svazku elektronů také fokusovaný iontový svazek (FIB z anlického focused ion beam), a jsou označovány jako SEM-FIB mikroskopy. Toto uspořádání, schematicky znázorněné na prvním obrázku, umožňuje díky usměrněnému toku ionizovaných atomů mikroobrábění pozorovaných vzorků, které je vhodné nejenom při přípravě fólií pro transmisní elektronový mikroskop, ale rovněž pro tzv. in situ experimenty v případě, je-li mikroskop vybaven nanoindentorem. Pro lepší představu takový experiment probíhá tak, že si v konkrétním místě, například v zrnu fáze vzniklé v materiálu, vytvoříme FIBem trámeček. Ten pak můžeme nanoindentorem natahovat nebo ohýbat a sledovat změny, ke kterým dochází, ale také přímo určit základní mechanické vlastnosti dané fáze.
Chcete se dozvědět víc? Vřele doporučujeme práci našich kolegů z Fyzikálního ústavu AV ČR.









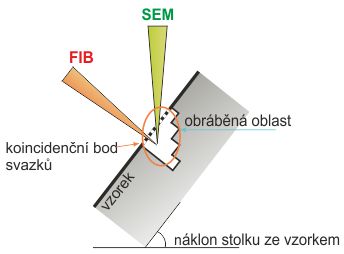
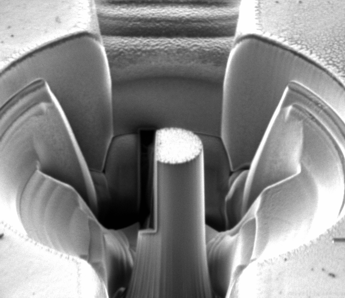
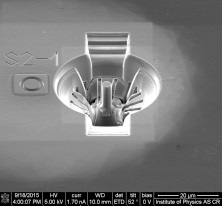
 Projekt NCK MATCA je podporován
Projekt NCK MATCA je podporován